-
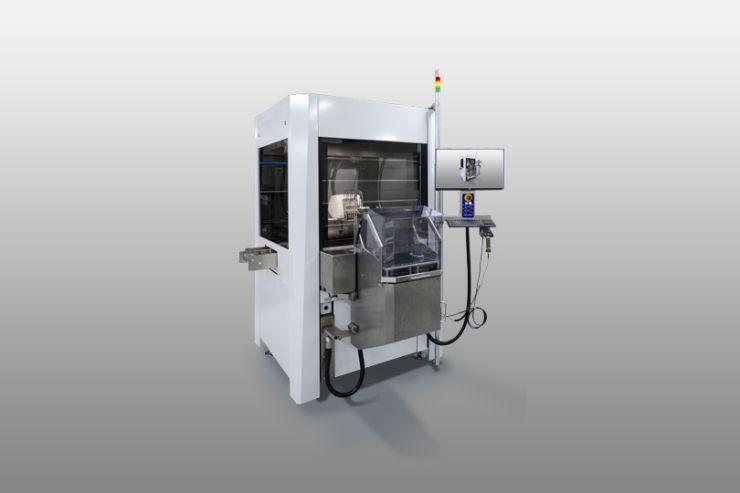
Hybrid Bonder
Flyer - Die / Hybrid Bonder
Sample Video - Hybrid Bonder
Applikationen - Die-Bonden
In der Welt der Mikroelektronik verschmelzen die Bereiche Die Bonden und SMD Bestücken immer mehr miteinander. Infotech antwortet darauf mit dem Hybrid Bonder, der sowohl Nacktchips direkt vom Wafer aussticht als auch beliebige eingehauste oder nicht eingehauste Bauteile aus Gurten, Waffle Trays, Gel-Paks® oder sonstigen Zuführformen aufnimmt.Wie alle anderen Infotech Maschinen kann auch der Hybrid Bonder Bestückaufgaben mit Dosierprozessen oder sonstigen Funktionen kombinieren.
-

Die Bonder
Flyer- Die / Hybrid Bonder
Applikationen - Die-Bonden
Der universell konfigurierbare Infotech Die Bonder bietet professionelle Lösungen für anspruchsvolle Prozesse mit diffizilen Bauteilen und Materialien und für die unterschiedlichsten Aufbau- und Verbindungstechniken. Halbleiterchips wie ASICs, IGBTs, Laserdioden, Photonik-Bauteile, Sensoren, Detektoren, MEMS, Imagesensoren, usw. werden direkt vom Wafer ausgestossen, abgepickt, ausgerichtet und bestückt.
Die Bonding-Techniken umfassen das klassische Die-Bonden mit Epoxyd- oder Leitklebern, Flip-Chip-Bonden, Eutektisch-Bonden, Thermokompressionsbonden, Ultraschallbonden und Sinterbonden. Zudem können die Chips sowohl auf Keramiksubstrate, Leiterplatten, Submounts, Folien oder anderen Trägern wie auch direkt auf Wafer (Chip-onWafer), auf andere Chips (Chip-on-Chip), oder auf sonstige Gehäuseformen bestückt werden.
Für die Präzise Einhaltung der Bond Line Thickness kann der Chip auf eine definierte Höhe über dem Substrat oder auf eine bestimmte Bondkraft bestückt werden.
-
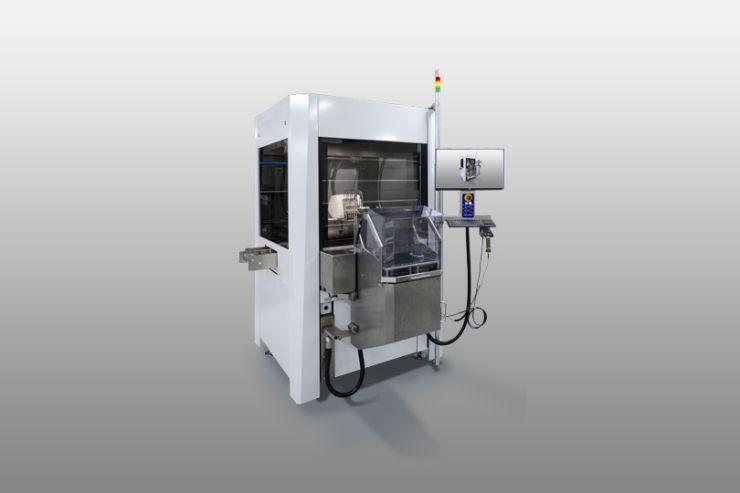
Hybrid Bonder
Flyer - Die / Hybrid Bonder
Sample Video - Hybrid Bonder
Applikationen - Die-Bonden
In der Welt der Mikroelektronik verschmelzen die Bereiche Die Bonden und SMD Bestücken immer mehr miteinander. Infotech antwortet darauf mit dem Hybrid Bonder, der sowohl Nacktchips direkt vom Wafer aussticht als auch beliebige eingehauste oder nicht eingehauste Bauteile aus Gurten, Waffle Trays, Gel-Paks® oder sonstigen Zuführformen aufnimmt.Wie alle anderen Infotech Maschinen kann auch der Hybrid Bonder Bestückaufgaben mit Dosierprozessen oder sonstigen Funktionen kombinieren.
-

Die Bonder
Flyer- Die / Hybrid Bonder
Applikationen - Die-Bonden
Der universell konfigurierbare Infotech Die Bonder bietet professionelle Lösungen für anspruchsvolle Prozesse mit diffizilen Bauteilen und Materialien und für die unterschiedlichsten Aufbau- und Verbindungstechniken. Halbleiterchips wie ASICs, IGBTs, Laserdioden, Photonik-Bauteile, Sensoren, Detektoren, MEMS, Imagesensoren, usw. werden direkt vom Wafer ausgestossen, abgepickt, ausgerichtet und bestückt.
Die Bonding-Techniken umfassen das klassische Die-Bonden mit Epoxyd- oder Leitklebern, Flip-Chip-Bonden, Eutektisch-Bonden, Thermokompressionsbonden, Ultraschallbonden und Sinterbonden. Zudem können die Chips sowohl auf Keramiksubstrate, Leiterplatten, Submounts, Folien oder anderen Trägern wie auch direkt auf Wafer (Chip-onWafer), auf andere Chips (Chip-on-Chip), oder auf sonstige Gehäuseformen bestückt werden.
Für die Präzise Einhaltung der Bond Line Thickness kann der Chip auf eine definierte Höhe über dem Substrat oder auf eine bestimmte Bondkraft bestückt werden.



